
光刻胶显影分析设备
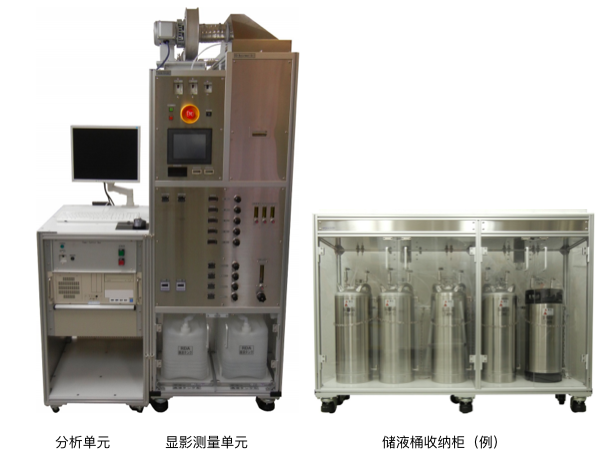
光刻胶显影分析装置(RDA)
RDA是测量,分析光刻胶在不同曝光量下的显影速度的装置。
由以下硬件和软件构成
1.硬件设备
- 分析单元
- 显影测量单元
- 储液桶收纳柜
2.软件概要
- 显影速度分析软件「LEAP SET」
- 显影参数计算软件「DPC」
用途
1.干涉波形(深度方向显影速度分布的把握)
2.残膜曲线(显影时间和膜厚变化的关系)
3.一定显影时间下的Eth(光刻胶敏感度)测量
4. γ 值计算(曝光量和残膜率的对比度曲线)
5.tanθ 值计算(曝光量和平均显影速度的对比度曲线)
6.利用这些功能,可以进行光刻胶的材料开发、清洗、simulation参数的 取得等。
7.可以测量ADR(树脂的显影速度),对树脂的品质管理有用。
干涉波形

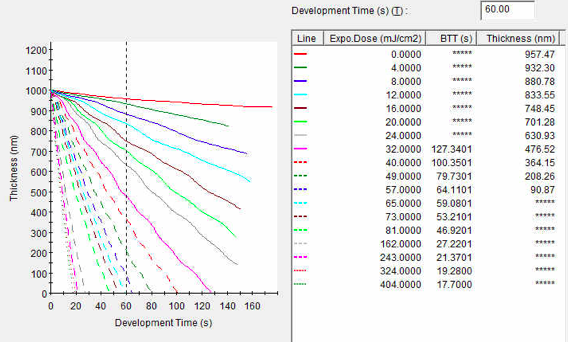
残膜曲线图
左图是残膜曲线图。
横轴是显影时间,纵轴是膜厚。
1,不同曝光量下显影时的残膜(膜厚)变化曲线
2,一定显影时间下的残留膜厚
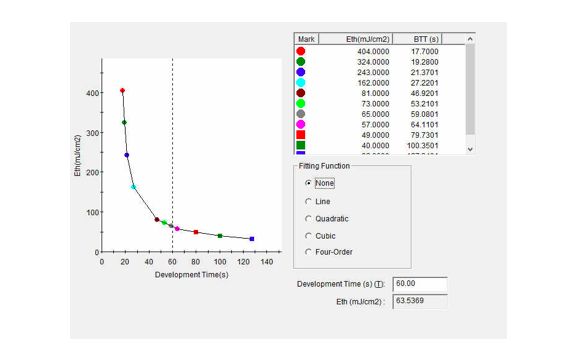
Eth(光刻胶敏感度)的测量
横轴是显影时间,纵轴是曝光量(Eth)。
用于测量一定显影时间下的Eth值
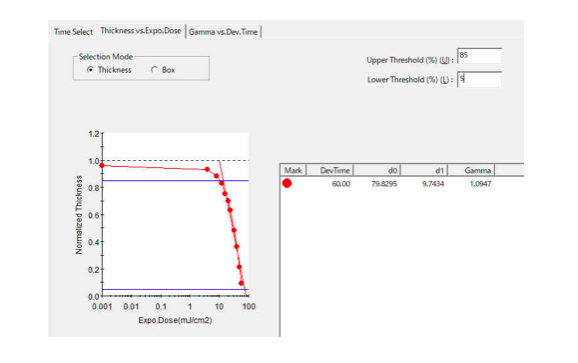
显影速度曲线( γ 值)
左图是显影速度曲线(曝光量和残膜率的变化关系)
横轴是曝光量,纵轴是残膜率。
通过该图表可得到显影对比度γ 值
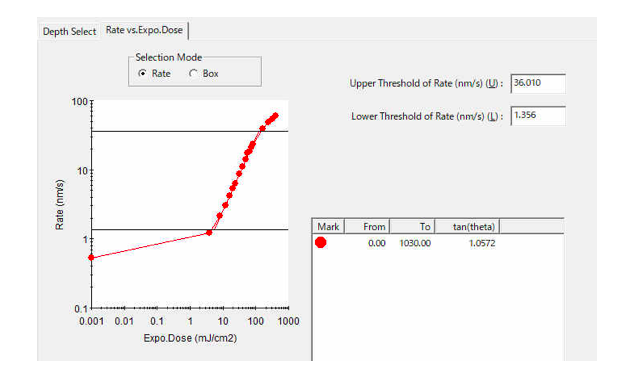
显影速度曲线的( tanθ )
显影速度曲线(曝光量和显影速度的变化关系)。
横轴是曝光量,纵轴是平均显影速度。
通过该图表可得到显影对比度tanθ值。
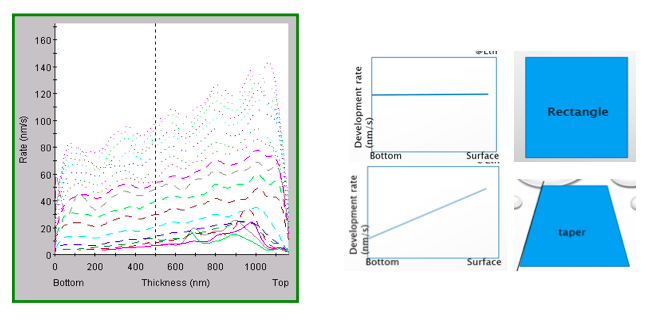
深度方向显影速度分布
图是深度方向显影速度分布曲线。
横轴是膜厚,纵轴是显影速度。

显影参数的获取
如左图所示,通过UVES-2000计算出ABC参数,将该参数输入到LEAPSET软件中,则可以计算出显影参数。
苏州优维毕光电科技有限公司 All rights reserved @ 2026.
苏州优维毕光电科技有限公司
苏州优维毕光电科技有限公司,提供172nm単一波长紫外光EUV整体清洗解决方案。
https://user-assets.sxlcdn.com/images/89216/FnA8u469BAFmtUq_mZWGTbkiBYXi.png?imageMogr2/strip/auto-orient/thumbnail/1200x630>/format/png


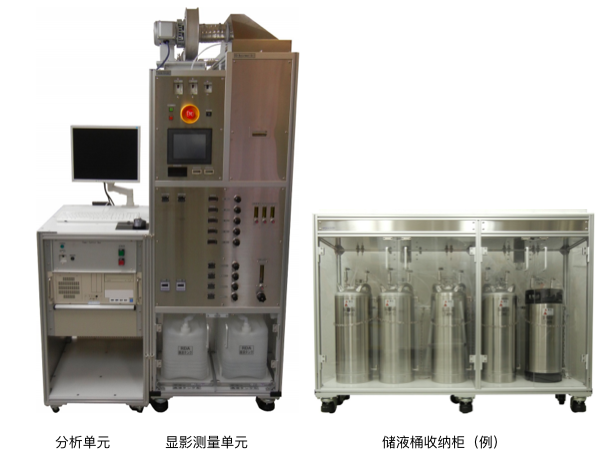

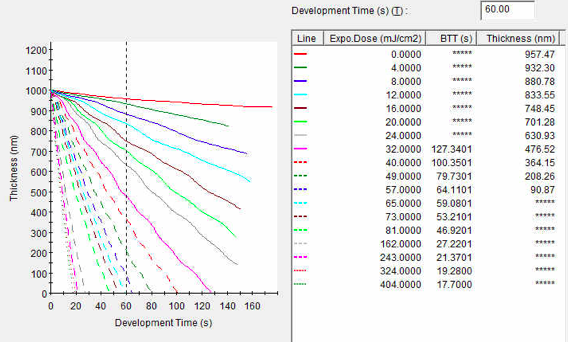
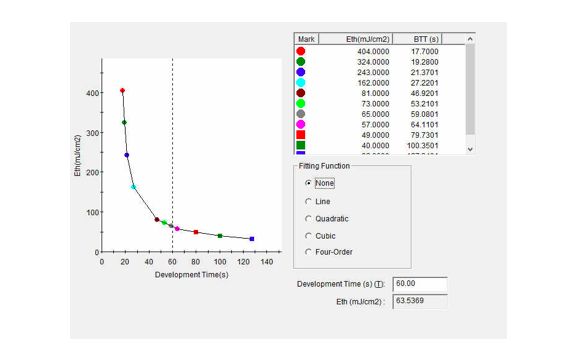
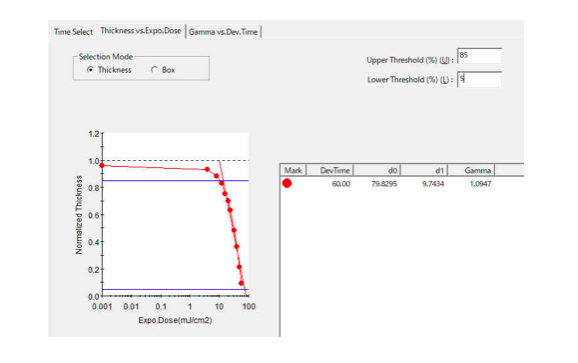
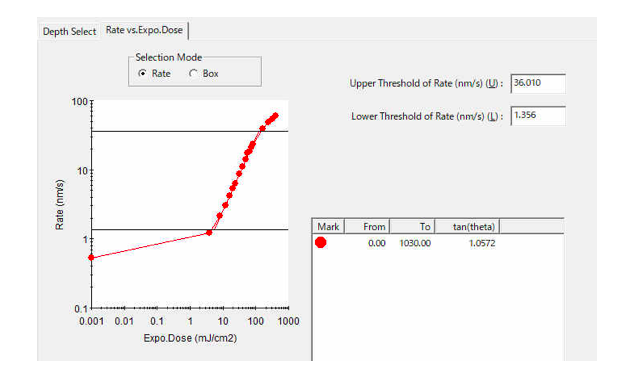
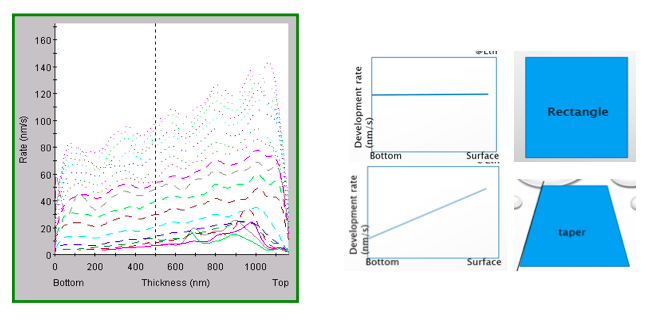

 苏公网安备32059002007087号
苏公网安备32059002007087号